초고밀도 충전에 의한 무소결 세라믹 기술 개발
김종희 요업(세라믹)기술원 융복합기술본부 본부장
구은회 요업(세라믹)기술원 융복합기술본부 책임연구원
윤영준 요업(세라믹)기술원 융복합기술본부 선임연구원
I. 개요 및 연구배경
전자산업 기술의 메가트랜드는 급속한 디지털 컨버젼스의 실현, 유비쿼터스 환경에 부응하기 위한 응용서비스 확대, 그리고 이종간의 산업으로부터 출발한 BT-NT-ET-IT 기술의 융합화로 대변될 수 있을 것이다. 이러한 유비쿼터스와 융합기술 환경 하에서는 모든 정보와 멀티미디어가 언제, 어디서나 24시간 끊김 없이 서비스가 가능하게 되며 이를 위해서는 항상 다양한 정보 및 서비스의 송신 및 수신이 동시에 가능한 휴대 단말기가 필요하게 될 것이다. 이러한 차세대 휴대 단말기는 현재 휴대폰의 전화기능, 카메라, DMB 이외에도 Mobile Internet, Health care서비스, Home network등 더욱 다양한 서비스가 가능해야 할 것이다. 그러기 위해서는 단말기의 일정한 volume내에 현재 보다 훨씬 많은 기능의 탑재가 필수적이며, 이에 단말기내의 부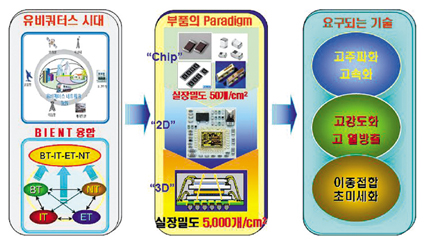 품 실장밀도의 급격한 증가가 요구되고 있다. 현재의 최대 부품 실장밀도를 50개/cm2정도로 보고 있는데, 위에 언급된 유비쿼터스 및 융합기술 환경을 만족시키기 위해서는 현재의 100배에 해당한 5000개/cm2가 요구되는 것으로 알려져 있다. 이러한 전자부품의 고밀도 집적에 대한 요구는 지금까지의 2차원적인 실장이 아닌 3차원 실장이라는 새로운 패러다임으로의 기술변화와 더불어, 수동부품과 능동부품의 실장을 별개로 추진해오던 것을 수동 및 능동부품을 하나의 패키지 내에 실장 가능한 시스템 패키징 또는 시스템 integration을 추진하고 있다. 3차원 시스템 integration
품 실장밀도의 급격한 증가가 요구되고 있다. 현재의 최대 부품 실장밀도를 50개/cm2정도로 보고 있는데, 위에 언급된 유비쿼터스 및 융합기술 환경을 만족시키기 위해서는 현재의 100배에 해당한 5000개/cm2가 요구되는 것으로 알려져 있다. 이러한 전자부품의 고밀도 집적에 대한 요구는 지금까지의 2차원적인 실장이 아닌 3차원 실장이라는 새로운 패러다임으로의 기술변화와 더불어, 수동부품과 능동부품의 실장을 별개로 추진해오던 것을 수동 및 능동부품을 하나의 패키지 내에 실장 가능한 시스템 패키징 또는 시스템 integration을 추진하고 있다. 3차원 시스템 integration
을 실현하기 위해서는 새로운 소재 및 공정에 대한 요구가 있다. 우선, 모든 부품이 휴대단말기 내에 장착되어 무선기능에 대응 가능하여야 하므로 고주파에서 작동이 되어야 하는 특성이 요구되며, 또한 패키징의 I/O의 증가에 의한 기판의 고강도가 요구되며, 높은 I/O에 의한 발열이 큰 기술적 이슈가 되어 고방열 특성의 소재가 절실히 요구되고 있다. 그리고 다양한 기능의 부품을 내장(embedded)시켜야 하므로 서로 다른 소재를 접합시켜야 하는 요구가 있으며, 고밀도 실장을 위해서는 전극 패턴닝의 L/S도 현재의 PCB 및 LTCC기술에서 100㎛내외에 머무르고 있으나 향후에는 20㎛내외의 초정밀 패터닝이 필요하게 될 것이다.
그러나, 현재 사용되고 있는 PCB의 소재는 epoxy계의 FR-4가 사용되고 있으나 위에 언급한 고주파특성 중 유전손실이 매우 큰 이유로 향후 5GHz이상 수십 GHz대 영역에서의 사용에 제한이 있다. 그러나 세라믹 소재는 대부분의 polymer소재에 비해 1/20 정도의 낮은 유전손실 값을 보이고 있어 향후 확대되는 고주파화에 적합한 소재로 평가되고 있다. 한편, 3-D integration을 위해서는 다양한 기능의 부품이 embedded되어야 하는 데 현재의 사용되어지고 있는 단일부품들 예를 들어, capacitor, inductor, 저항, varistor 및 각종 필터류 등의 70% 이상이 세라믹소재로 제조되고 있다. 이러한 상황에서 3-D integration용 내장소자의 소재로서 다양한 세라믹소재 간의 이종접합을 이용한다면 다양한 소자의 내장기술 개발이 가능할 것이다. 또한 강도 면에서도 기존의 polymer 소재보다 강하여 고강도가 요구되는 패키징에서는 현재도 LTCC소재가 선호되고 있는 실정이다. 또한 세라믹 소재 중에는 polymer와 비교하여 매우 높은 열전도도를 갖는 소재들이 있어 이를 기판화하여 사용한다면 고방열에 대한 좋은 해결책이 될 수 있을 것이다.
2. 연구목표 및 연구전략
가. 전자세라믹 소재의 원천적인 문제점 및 해결방안
앞에서 부품의 새로운 paradigm인 3-D integration의 실현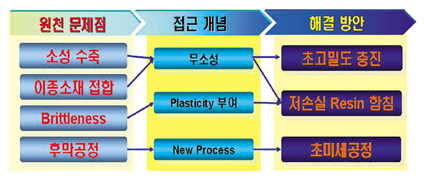 을 위해서 세라믹 소재의 다양한 유용성이 충분히 언급되었다. 그러나 세라믹 소재의 이러한 유용성에도 불구하고 현재 활발한 실용화가 이루어지지 못하고 있는 실정이다. 여기에는 세라믹소재가 가지고 있는 몇 가지의 원천적인 문제점에 기인하고 있다.
을 위해서 세라믹 소재의 다양한 유용성이 충분히 언급되었다. 그러나 세라믹 소재의 이러한 유용성에도 불구하고 현재 활발한 실용화가 이루어지지 못하고 있는 실정이다. 여기에는 세라믹소재가 가지고 있는 몇 가지의 원천적인 문제점에 기인하고 있다.
첫째 대부분의 세라믹소재를 이용한 부품제조에는 수백 ℃에서 수천℃에 이르는 고온에서 처리함으로써 밀도를 높이고 소재로서의 특성을 얻으며 형태를 유지하는 소결공정이 필수적이다. 이러한 소결공정을 거치면 세라믹 body는 약 13%이상의 수축이 발생하게 되어서 3-D구조상의 복잡한 패턴 및 via.등의 alignment에 치명적인 문제가 야기되고 있다. 또한 고온에서 행해지기 때문에 polymer를 비롯한 다양한 다른 세라믹 소재 간의 접합이 매우 어렵다. polymer는 350℃이상에서는 분해 되어 특성을 유지하지 못하며, 다른 종류의 세라믹 소재간의 접합에서도 통상의 소결온도에서는 분자간의 확산에 의해서 접합부의 화학적 조성이 변화하는 결정적인 문제가 있다.
또한 세라믹 소재는 경도 및 강도 면에서는 타 소재와 비교해 월등히 우수한 특성을 보이나 취성(brittleness)이 매우 커 충격에 약하다는 근본적인 단점을 가지고 있다. 고로 부품의 집적도가 급격히 높아져서 고강도의 소재가 필요한 차세대 휴대단말기에서는 휴대하는 특성 때문에 강도이외에 낙하 시험 등 여러 충격환경에서도 잘 견딜 수 있는 소재특성이 요구되고 있다. 즉 I/O수가 증가하면서 기판 등의 고강도가 요구되는 조건에는 만족할 수 있으나, 세라믹 소결체 내부의 여러 결함에서 기인되는 crack 전도에 의한 파괴는 휴대용이라는 향후의 기기의 특성에 대응하는 데 큰 단점으로 작용하고 있다. 현재까지의 성형, 전극형성 및 펀칭 등 세라믹 가공공정의 정밀도는 100㎛내외 인 반면 향후 요구되는 3-D integration기술에서는 30㎛정도의 초정밀 공정이 요구되고 있다.
예를 들어, 전극형성 기술은 통상 스크린 프린팅에 의하여 이루어지고 있으며, 펀칭도 최소 50㎛내외의 via.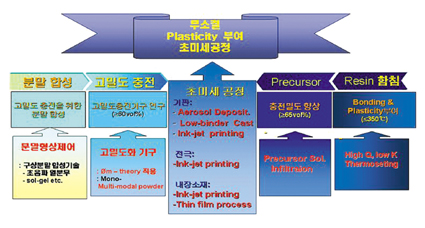 가 적용되고 있다. 또한 세라믹 성형은 sheet 성형은 수㎛ 내지 그 이하까지 가능하게 개발은 되었으나 이는 극히 일부의 부품에만 활용되고 있다. 이와 같이 세라믹 소재의 여러 유용성에도 불구하고 언급되어진 4가지의 결정적인 문제점 때문에 세라믹소재의 활용범위가 한정되어지고 향후 3-D integration기술에서도 하나의 후보 소재에 머무르고 실용화가 늦어지고 있는 현실이다.
가 적용되고 있다. 또한 세라믹 성형은 sheet 성형은 수㎛ 내지 그 이하까지 가능하게 개발은 되었으나 이는 극히 일부의 부품에만 활용되고 있다. 이와 같이 세라믹 소재의 여러 유용성에도 불구하고 언급되어진 4가지의 결정적인 문제점 때문에 세라믹소재의 활용범위가 한정되어지고 향후 3-D integration기술에서도 하나의 후보 소재에 머무르고 실용화가 늦어지고 있는 현실이다.
이러한 세라믹 소재의 원천적인 문제점을 해소하기 위한 개념으로는 앞에서 언급된 세라믹 소재의 고온에서의 소결공정을 없애면 수축에 의한 alignment의 문제점이나 확산에 의한 이종소재의 결합을 해결할 수 있으며, 세라믹 소재에 plasticity를 부여한다면 충격에 대응하는 소재가 될 수 있을 것이다. 또한 수 ㎛까지 가공이 가능한 공정기술이 개발된다면 초정밀 가공이 가능한 소재로서 활용이 가능할 것이다. 이러한 접근 개념을 통해 세라믹소재의 원천적 문제점을 해소하는 해결방안을 제시할 수 있다. 소결공정을 생략하기 위해서는 일단 세라믹 분말의 충전밀도를 가능한 한 높게 하고 plasticity를 부여하기 위하여 polymer resin을 첨가할 수 있을 것이다.
또한 이러한 충전밀도를 높이고 resin을 첨가하는 공정을 미세하게 행할 수 있는 초미세 공정으로 한다면 세라믹 소재가 matrix로서 세라믹 소재의 특성을 유지하고 적은 량의 resin이 함유되어 강도와 충격에 강한 ductile하면서 미세성형이 가능한 소재개발이 가능할 것이다. 이와 같이 언급된 세 가지, 초고밀도 충전, resin 함유 및 초정밀 공정이 동시에 개발 가능하다면 세라믹 소재가 원천적으로 가지고 있던 단점이 동시에 해결되는 결과를 얻을 수 있을 것이다.
특히 이러한 개발이 실용화에 성공한다면 세라믹 소재가 단지 3-D integration소재로서 만이 아니라 더욱 많은 응용이 가능하여 세라믹 소재 활용범위의 획기적인 전개가 이루어질 수 있을 것이다.
나. 3-D integration 소재의 연구개발 전략
본 과제의 추진전략은 앞 절에서 언급되어 있듯이 개발내용의 원천성이 강조되고 있다. 고로, 현시점에서 전자 세라믹소재의 원천적인 문제점인 소성수축, 이종접합 불가, 세라믹 취성 및 후막공정에 의한 미세공정 불가 등 4가지의 단점을 동시에 해결하는 기술을 개발함으로써 그 원천성을 갖는다. 이러한 개념에서 이 과제 추진 상에서 부각되어야 할 핵심단어는 무소결, 초미세공정 및 plasticity 부여 등 3가지 요소이다. 무소결에 대한 개발전략은 세라믹 분말의 최대 고밀도 충전함으로써 60vol%를 실현하는 것을 목표로 하고 있다. 이를 위해서는 고밀도 충전을 위한 학문적인 연구가 먼저 이루어져야 할 것이며 현재 제안되는 theory로서는 1960대에 미국을 중심으로 수 cm 크기의 입자에 대한 최대 충전밀도를 구하는 연구가 진행된 바 있다. 본 과제에서는 이 이론을 현재 주로 사용되는 세라믹 분말 크기에 이르는 범위에 적용하여 보고 이 이론에 수정을 하여 나름대로의 theory를 도출 할 계획이다. 또한 이러한 이론을 기초하여 여러 경우의 분말의 형태와 크기에 변화를 가지고 가는 simulation작업을 통하여 각 공정에 맞는 분말의 모델링이 이루어질 계획이다. 또 다른 무소결에 대한 개발 전략은 고밀도 충전에 의해서 얻어진 세라믹 layer에 충전율을 더욱 향상시키기 위하여 현재 많은 연구가 이루어지고 있는 precursor기술을 이용하는 것이다. precursor가 함유된 solution을 앞의 고밀도 충전 과정에서 어느 정도의 고밀도가 얻어진 세라믹 body에 이 precursor solution을 body의 분말간의 공간에 infiltration시킴으로써 충전율을 향상시키는 개념이다. 이 때 생성되는 분말의 입도는 기존 body에 있는 수 십㎛에서 수 백 nm에 이르는 것과는 달리 수~수 십㎚ 크기의 입자가 형성될 것으로 예상하고 있다.
초미세공정은 앞에서 언급된 무소결을 위한 공정 이외에 본 과제의 실용화는 차세대 3-D integration에 적용되어야 하므로 미세 전극형성 및 내장(embedded)소재의 형성에도 활용이 되어야 한다. 이를 위해서는 최대 고밀도 충전을 위한 공정으로부터 저온에서 수 십 ㎛의 L/S를 갖는 전극형성과 embedded용 후막 및 박막의 미세가공이 가능할 수 있는 공정을 선택하였다. 그 결과 Aerosol Deposition, Wet process 및 Ink jet print공정을 선택하였다. 이와 같이 다양한 공정을 선택한 이유는 본 과제의 개발은 아직 수행된 사례가 거의 없는 상태에서 여러 방법에 의해 시도함으로써 개발의 risky한 면을 줄이는 효과도 고려하였다. 또한 각 공정들은 향후의 중요한 공정으로 평가되고 있으며 이 과제를 통하여 새로운 연구개발을 이룰 수 있다는 면에도 또 다른 의미가 있을 것으로 사료된다. Plasticity부여에 대한 개발은 낮은 유전손실과 낮은 유전율을 가지는 열경화성(thermoset) resin을 선택하여 앞 공정에서 얻어진 고밀도 충전된 세라믹 body에 함침(infiltration)시키는 공정이다. 이 공정에서는 세라믹 body에 plasticity만을 부여하는 것이 아니라 세라믹 입자 간의 bonding에도 크게 기여 할 것으로 사료된다. 이상과 같이 3가지의 원천성 요소를 만족시키는 연구개발은 크게 5개의 개념으로 정리될 수 있다. 그 개념들은 분말합성, 고밀도충전 기구연구, 초미세공정에 의한 세라믹 layer형성, precursor infiltration 및 resin infiltration 기술의 개발에 의해 이루어지며, 지금까지 설명한 연구개발 전략을 그림 3에 정리하였다.
3. 파급효과 및 결론
본 연구개발의 성공 시 차세대 단말기 및 시스템간 융합화, 다기능화가 요구되는 다양한 분야에서 그 파급 효과가 지대할 것으로 예상된다. 첫째, 기술적 파급 효과로서 원천기술 확보로 기술종속화 방지 및 그에 다른 소재산업의 국제경쟁력 강화를 들 수 있겠다. 둘째, 경제적 파급효과로서 2014년 IT관련 초고집적 3D 세라믹 모듈의 세계시장은 약 24조원 예상되는 IT관련(RF/Passive module, package) 및 다층기판 소재 시장의 급속한 변화 주도할 수 있을 것이다. 또한, 매년 연간 300%성장률 및 2010년 57억달러에서 2013년 172억달러로 거대한 시장이 형성되는 e-haelthcare 같은 연관 산업에 대한 파급 효과 또한 지대할 것으로 예상된다.
<그림설명 위에서 부터>
그림 1. 전자산업 기술의 Mega Trend 및 부품의 새로운 paradig
그림 2. 전자세라믹 소재의 원천적 문제점 및 해결방안
그림 3. 3D 세라믹 Integration 연구개발전략
 김종희
김종희
동경공업대학 무기재료공학과 공학박사
국방과학연구소 연구원
한국뉴세라믹연구소 선임연구원
삼성전기연구원(상무)
요업(세라믹)기술원 융복합기술본부 본부장
기사를 사용하실 때는 아래 고유 링크 주소를 출처로 사용해주세요.
https://www.cerazine.net