장병국 物質·材料硏究機構, 나노세라믹센타 주간연구원
1. 서론
탄화규소(Silicon Carbide, 화학식 SiC)는 비산화물 세라믹스의 대표적인 재료의 하나이며, 1884년에 E.G. Acheson가 처음으로 합성에 성공한 이후로, 분체, 단결정, 섬유, 소결체, 박막 등 여러 가지 형태로 이용되고 있다.
SiC는 구조재료로서의 우수한 고온강도, 내산화성, 내식성, 내열성 등을 갖고 있으며, 특히 넓은 밴드갭과 높은 절연 파괴 전계, 그리고 높은 포화 전자 드리프트 속도 등의 뛰어난 전자 물성을 가지기 때문에, 하이파워, 고주파 영역에서의 반도체 재료로서도 큰 기대를 모으고 있다[1].
SiC는 상압에서 융점을 갖지 않기 때문에, 일반적으로 PVD(Physical Vapor Deposition)법에 의한 박막형성은 용이하지 않다. 그 때문에, 전자 디바이스 등의 일부의 용도에 있어서, MBE(Molecular Beam Epitaxy) 법[2] , 승화법(개량 레이리법)[3]이 이용되고 있는 것 이외에는, 대부분은 CVD(Chemical vapor Deposition) 법[4]에 의해 성막 되고 있다.
CVD법은, 원료 가스에 에너지를 공급하여 화학반응을 제어함으로서, 박막이나 미립자등을 형성하는 재료 창제 프로세스이다. 원료 가스의 조합에 의해 다양한 재료를 취급할 수 있으며, 미세한 패턴이나 복잡 형상에도 균일한 코팅이 가능하다 따라서, 반도체 제조 프로세스를 비롯하여 그 응용범위는 넓다. 여기에서는, CVD-SiC 코팅 기술의 현상과 코팅 재료의 특징 및 그 응용 예에 대해 서술하고자 한다[5].
2. SiC세라믹스
먼저, 본론에 앞서 SiC 개요 및 특징, 용도에 대해 간단히 서술하고자 한다.
SiC는, 탄소(C)와 규소(Si)가 1:1의 비율로 이루어진 화합물로서, 천연에서는, 운석 중에 약간의 존재가 확인되고 있다. 광물학상으로는 모아사나이트(moissanite)로 불려19 세기말에 공업화한 회사의 상품명으로부터「카보란담」이라고 불리기도 하며, 분말은 흑색 또는 녹색의 색깔을 나타내고 있다.
SiC는 내마모성, 고온 강도, 화학적 안정성에 뛰어나기 때문에, 연마재나 펌프용 메카니칼 씰, 내화물, 구조재료용 부품, 발열체등의 용도에 오래전부터 사용되어 왔다. 또한, 반도체의 성질을 가지기 때문에 전자소자의 소재로도 사용된다.
전기 소자의 소재로서는, 발열체, 아레스타, 바리스터 등에 오래 사용되어 왔다. 실리콘에 비해 밴드 갭이 크므로, 고온, 고선량(線量)하에서 이용할 수 있는 반도체 재료로서 주목받아 1980년대 이후의 결정 성장 기술의 발전이 뒷받침되어, 청색 발광 다이오드, 고속 쇼트 키 바리어 다이오드, MOSFET(전계 효과 트랜지스터) 등에 사용되게 되었다. 또한, SiC는 열전도율이 높기 때문에, 다른 반도체의 기판으로도 사용되며, 구조 세라믹스로서의 내열, 내식부재로서 널리 사용되기도 한다.
특히, 최근에는 반도체 제조 프로세스 재료나 디젤차에서 배출하는 배기가스 입자장 물질 제거 필터(DPF), 파워 디바이스용 단결정 기판, 우주용 반사식 망원경 밀러 등에 실용화가 진행되고 있어, IT, 환경, 에너지, 우주분야에서 신규용도로서 급속히 확산되고 있다.
3. 화학 기상증착법
(CVD: Chemical Vapor Deposition)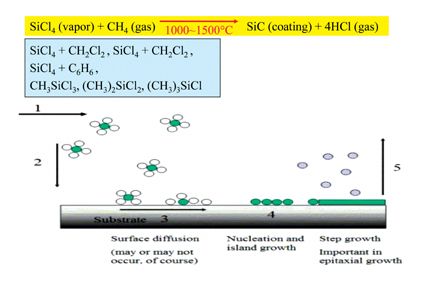 3.1 CVD의 개요
3.1 CVD의 개요
CVD법에 의한 막형성 과정은, 그림1에 나타낸 것 같이 5가지의 과정으로 설명할 수가 있다. [I]반응 가스 혹은 반응 전구체의 기판에의 수송(기상 확산), [II]기판 표면에 흡착 및 표면 확산, [III]표면 반응, 핵형성 또는 집적, [IV]반응 생성물의 이탈, [V]이탈반응 생성물의 바깥쪽으로 확산 (기상 확산) 등이다.
CVD법의 기본은 상기의 반응을 제어하는 것이다. CVD법은 일반적으로 반응을 여기(餘起)하기 위한 공급 에너지에 의해서 분류된다. 표1에 CVD법의 분류를 나타내었다. 열에너지에 의한 여기가 가장 기본적인 방법이지만, 최근에는 플라스마나 광(레이저) 등을 보조적으로 이용해 반응 온도를 저하시키는 방법이 주류가 되고 있다.
CVD법의 장점으로서, 높은 증착속도, 높은 재현성, 에피탁샬 성장, 치밀한 막의 제조 등이고, 단점으로서는 높은 반응온도, 복잡한 프 로세스, 유해한 가스의 사용 등을 들 수가 있다.
로세스, 유해한 가스의 사용 등을 들 수가 있다.
3.2 CVD의 종류
아래에 CVD법의 종류와 특징을 간단히 설명한다.
3.2.1 열 CVD법
열CVD법은 열에너지에 의해서 화학반응을 여기(餘起)시켜 성막 하는 방법으로, 가장 널리 보급되어 있는 기본적인 기술이다. 그림2에 전형적인 핫 월(Hot wall)형 감압 CVD 장치의 개략도를 나타내었다[6]. SiC의 경우, Si의 원료 가스로서 SiC14나 SiH2C12등 , C의 원료 가스로서 CH4나 C2H2, C3H8등을 , 캐리어 가스로서 H2가스가 이용된다. 이러한 원료 가스의 조성, 유량, 유속, 압력 및 기판 온도를 제어하는 것에 의해서, 각각의 용도에 맞는 코팅 막을 제조 할 수 있다.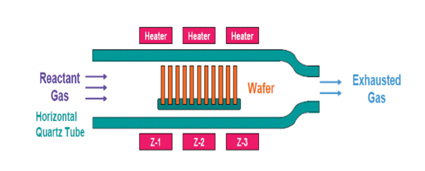
3.2.2 플라스마 CVD법
이 방법의 경우, 원료 가스는 미리 플라스마 분해되어 화학적으로 활성화된 래디칼이나 이온이 되어, 이것들이 기판 표면에 흡착하여 막을 형성한다. 이 때문에, 기판 가열만으로 반응을 여기하는 열CVD법보다도 저온에서 성막이 가능하다. 다만, 플라스마 CVD법의 경우, 캐리어 가스로서 이용되는 N2나 H2 등이, 분해되어 막 형성 화학반응에 관여하기 때문에, 막중에 혼입되는 것은 피할 수 없는 것에 유의할 필요가 있다. 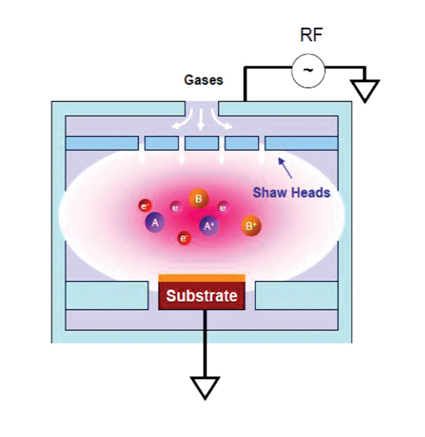 플라스마의 발생 방식은, 용량 결합 방식(평행 평판형)과 유전결합형(코일형 방식)의 2가지로 분류된다. 그림3에 전형적인 용량 결합형 플라스마 CVD 장치의 것을, 그림4에 유도 결합형 플라스마(ICP) CVD 장치의 개략도를 나타낸다.
플라스마의 발생 방식은, 용량 결합 방식(평행 평판형)과 유전결합형(코일형 방식)의 2가지로 분류된다. 그림3에 전형적인 용량 결합형 플라스마 CVD 장치의 것을, 그림4에 유도 결합형 플라스마(ICP) CVD 장치의 개략도를 나타낸다.
플라스마 CVD에서는, 플라스마 여기 주파수에 고주파(RF대: 13.56 MHz)를 사용하는 것이 많다. 그 이유로서는, 13.56 MHz가 기술적으로 확립된 주파수인 점, 마이크로파와 같이 도파(導波)관을 필요로 하지 않고 취급이 용이한 점, 이온 충격이 적은 점 등을 들 수 있다.
보다 고속이고 균일한 성막을 실시하기 위해서는, 저압·고밀도 플라스마를 안정적으로 생성시킬 수 있는 전자 사이클로트론 공명(ECR) 플라스마를 이용하는 것이 유효하다[7]. 최근에는, VLSI용 다층 배선 등의 반도체 프로세스를 중심으로, ECR 플라스마 CVD법의 응용 연구가 활발하게 행하여지고 있다.
그림 5에 ECR 플라스마 CVD 장치의 구성도 [8]를 나타내었다. 마이크로파를 도파관에 의해서 석영 유리창으로부터 플라스마 생성실에 도입시켜, 마그네트 코일을 이용하여, 충분한 자속밀도의 자장을 형성하여, ECR 모드에서의 마이크로파 흡수가 일어나는 구조로 되어 있다.
저압·고밀도의 플라스마는 인출창으로부터 유출, 확산하여 시료홀더에 도달해, 낮은 기판 온도에서도 특성이 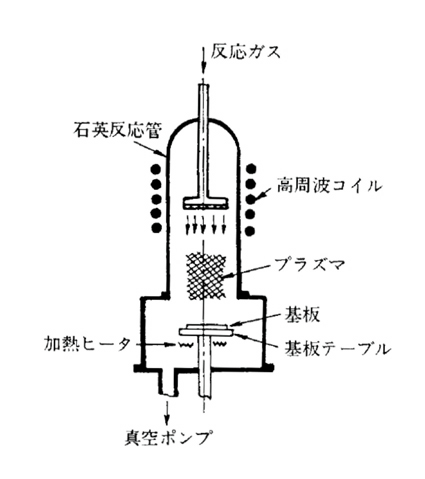
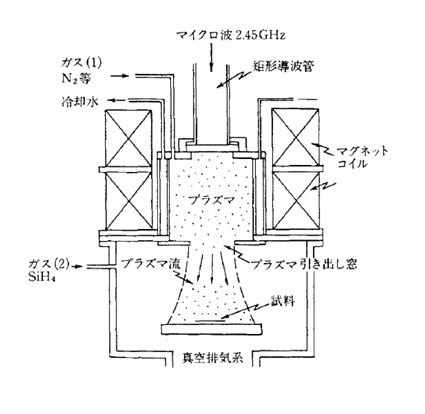 뛰어난 피막 형성이 가능해진다.
뛰어난 피막 형성이 가능해진다.
3.2.3 광CVD법
광CVD법은, 광화학 반응을 이용하여 성막을 실시하는 기술이다. 반응여기(餘起)에는, 자외선이나 X선을 여기 빛으로써 이용하는 경우의 전자 여기와 적외선을 이용하는 경우의 진동 여기가 있으며, 빛 에너지를 선택하는 것에 의해서, 특정의 반응만을 제어하는 것도 가능하게 된다. 광CVD법에서는, 플라스마 CVD법에 비해, 국소적인 고에너지 밀도장을 형성할 수 있기 때문에, 전체적으로 투입 에너지를 적게 할 수 있다. 그 때문에, 고에너지 상태의 이온이나 전자가 반응 실내의 벽 등을 스팟타하여 불순물을 방출할 것도 없고, 깨끗한 프로세스의 실현이 가능하다.
또한, 기판에 여기광을 조사(照射)함으로서, 기판 표면에서의 전자 여기나 가열 효과를 제어하는 것도 가능하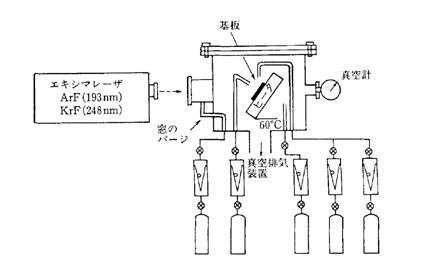 다. 특히, 레이저와 같은 지향성·집광성이 뛰어난 빛을 사용하면, 미소 영역에서의 성막 제어(패터닝)도 가능하다[9]. 그림6에 엑시머 레이저 CVD 장치의 개략도를 나타내었다. 광CVD법은 응용범위가 넓어지고 있지만, 성막 속도나 성막 면적 등에 있어 기존의 CVD법과 비교해 아직 뒤떨어지는 점도 많아, 향후의 전개여부는 고효율이며, 고강도인 광원의 개발에 달려있다.
다. 특히, 레이저와 같은 지향성·집광성이 뛰어난 빛을 사용하면, 미소 영역에서의 성막 제어(패터닝)도 가능하다[9]. 그림6에 엑시머 레이저 CVD 장치의 개략도를 나타내었다. 광CVD법은 응용범위가 넓어지고 있지만, 성막 속도나 성막 면적 등에 있어 기존의 CVD법과 비교해 아직 뒤떨어지는 점도 많아, 향후의 전개여부는 고효율이며, 고강도인 광원의 개발에 달려있다.
4. CVD-SiC 코팅의 응용
SiC가 지닌 뛰어난 재료 특성을 응용하는 것을 목적으로, CVD-SiC 코팅의 연구 개발은 다양한 분야에서 행해지고 있다. 주된 용도로서는, 파워 반도체 디바이스, 내열·내산화성 코팅, 습동(招動)재료, 자외선광용 밀러, 반도체 프로세스용 부품 등을 들 수 있다.
아래에서는 최근의 주된 기술분야에 대해서 CVD-SiC 코팅 기술의 응용사례와 기술적인 특징 등을 서술하였다.
4.1 파워 반도체 디바이스
SiC는, p, n 모두, 전도형의 제어가 용이한 와이드 밴드 갭 반도체로, 절연 파괴 전계가 Si보다 한자리수 높고, 포화 드리프트 속도, 열전도도도 높은 특징을 가지기 때문에, 기존의 반도체 Si나 CaAs에서는 실현 불가능한 대용량·저손실 파워 디바이스, 내환경 디바이스용 재료로서 기대되고 있다. SiC는 동일 조성에서 1 차원적인 적층 구조가 다른 결정인 다형(폴리 타입)을 나타고 있고, 그 중에서도 저온 안정다형인 3 C-SiC, 고온 안정 다형인 4 H-SiC와 6 H-SiC에 대한 연구예도 많다.
SiC 단결정 기판으로서는, 승화법에 의해 육성된 1 인치 정도의 4 H-SiC와 6 H-SiC가 이미 시판되고 있다. 이것에 스텝 제어 에피탁시법 [10]에 의해서 4 H-SiC, 6 H-SiC 피막을 호모 에피탁셜 성장시킴으로서, 고내압 다이오드, 고주파 파워 디바이스, 고집적회로등에 적용되고 있다. 한편, 3 C-SiC는 전자 이동도의 관점에서4 H-SiC나6 H-SiC보다 뛰어나지만, 대형의 결정 성장이 어렵기 때문에, 일반적으로 Si기판상에 CVD법에 의해, 헤테로 에피탁셜 성장시켜 형성된다. 이러한 3 C-SiC막에는 결정 결함의 문제가 남아 있어, 이것을 해결하기 위해서는 저온에서의 성막이 필수적이다. 그 방안으로서, 실란, 프로판계 이외의 새로운 원료 가스의 탐색이 행하여지고 있고, 그중에서도 단일 원료 중에 Si와 C를 포함한 메칠실란이나 헥사메칠실란 등의 유기 실란계의 원료가 유망시 되고 있다.
4.2 내열·내산화성용 재료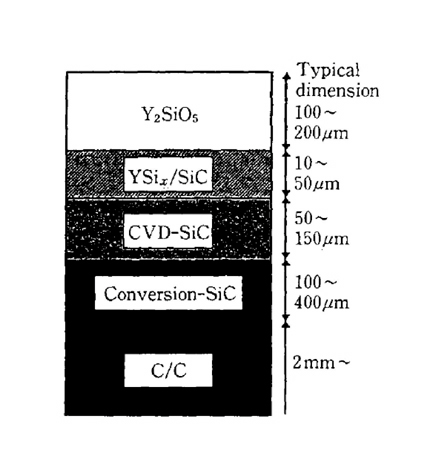 탄소섬유 강화 탄소 재료(C/C복합재료)는 2000도 이상에서도 사용 가능한 경량 내열 구조재료로서 우주 왕복선이나 가스터빈 브레이드 등으로의 적용이 기대되고 있다. 하지만, 통상의 탄소 재료와 마찬가지로, 500도 이상에서 급격하게 산화를 일으키기 때문에, 안전사용을 위해서는 내산화성의 부여가 필요 불가결하다. 미국 NASA의 스페이스 셔틀에서는, C/C복합재료표면에 CVD-SiC 코팅을 행한 부품이 노즈 콘 등에 실용화되고 있고, 약 1800도까지는 사용 가능하다. CVD-SiC코팅에 의한 산화 방지 메카니즘은, 기본적으로 표면에 형성된 Si02에 의해서 표면이 씰링 되어 그 이상의 산화 반응의 진전을 더디게 하는 것이다. 이 때문에, 안정한 유리상을 형성하기 위해서, 붕소를 첨가하는 방법 [11], 그림7과 같이 CVD―SiC코팅표면에 미리 유리상을 형성시키는 방법[12]등이 검토되고 있다. 또, 벌크 재료에 코팅하는 것이 아니라, 섬유 표면에 SiC를 코팅하는 방법[13], CVI (Chemical Vapor Infitration) 법에 의해 매트릭스에 SiC를 이용하는 방법 등도 시도되고 있다.
탄소섬유 강화 탄소 재료(C/C복합재료)는 2000도 이상에서도 사용 가능한 경량 내열 구조재료로서 우주 왕복선이나 가스터빈 브레이드 등으로의 적용이 기대되고 있다. 하지만, 통상의 탄소 재료와 마찬가지로, 500도 이상에서 급격하게 산화를 일으키기 때문에, 안전사용을 위해서는 내산화성의 부여가 필요 불가결하다. 미국 NASA의 스페이스 셔틀에서는, C/C복합재료표면에 CVD-SiC 코팅을 행한 부품이 노즈 콘 등에 실용화되고 있고, 약 1800도까지는 사용 가능하다. CVD-SiC코팅에 의한 산화 방지 메카니즘은, 기본적으로 표면에 형성된 Si02에 의해서 표면이 씰링 되어 그 이상의 산화 반응의 진전을 더디게 하는 것이다. 이 때문에, 안정한 유리상을 형성하기 위해서, 붕소를 첨가하는 방법 [11], 그림7과 같이 CVD―SiC코팅표면에 미리 유리상을 형성시키는 방법[12]등이 검토되고 있다. 또, 벌크 재료에 코팅하는 것이 아니라, 섬유 표면에 SiC를 코팅하는 방법[13], CVI (Chemical Vapor Infitration) 법에 의해 매트릭스에 SiC를 이용하는 방법 등도 시도되고 있다.
그림8에 CVI법의 개략도를 나타내고 있다. CVI법은, 섬유프리폼의 공간에 CVD 원료 가스를 흘려, 섬유 표면에 매트릭스를 석출시키는 것으로, 복합화에 의한 치수 변화가 적고, 복잡 형상을 한 복합재료를 제조할 수 있다는 장점이 있다. 한편, CVI법의 단점은 석출의 진행과 함께 가스의 통과구멍이 작아져, 석출 속도가 저하하는 것이다. 이런 결점을 극복하기 위해서 개발된 것이, 펄스 CVI법이다. 펄스 CVI법에서는, 반응실을 진공으로 한 후, 신선한 반응 가스를 보내, 몇 초간 유지한 후에 다시 진공시키는 사이클을 반복함으로서, 공간의 세부까지 매트릭스를 석출시킬 수 있다.
4.3 습동재료
소결제 SiC는, 수중 펌프의 축수부품 등의 습동재료로써 널리 사용되고 있지만, CVD-SiC 코팅은 별로 이용되지는 않았다. 소결 SiC는 수중에서 매우 뛰어난 마찰·마모 특성을 나타내고 있다. 그 메카니즘에는 유리 카본(graphite)의 존재가 크게 관여하고 있기 때문이다.
CVD-SiC 피막의 경우는, 유리 카본을 포함하지 않기 때문에 마찰 특성에서는 뒤떨어지지만, 결함이 적은 견고한 표면 형성이 가능함으로, 볼베어링과 같이 국소적으로 높은 응력을 받는 표면에 적용하는 연구도 행해지고 있다. 또, 간접적이기는 하지만, 알루미나 소결체에 다이아몬드 라이크 카본(DLC)을 코팅 할 때, 밀착성 향상을 위해 중간층에 RF플라스마 CVD에 의한 아몰퍼스(amorp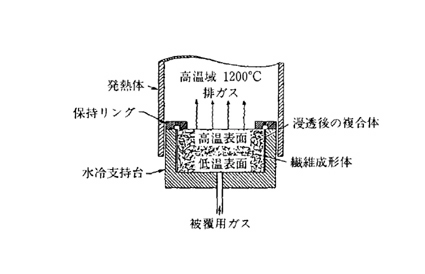 hous) SiC 코팅을 행함으로서, 수전(水栓)밸브 재료로서 실용화되고 있는 예도 있다. 습동재료로써 CVD-SiC 코팅은, 소결체나 다른 경질 피막에 비해 현재 우위성은 없지만, 탄소의 조성비나 구조를 제어함으로서, 새로운 전개를 도모할 수 있는 가능성이 있다.
hous) SiC 코팅을 행함으로서, 수전(水栓)밸브 재료로서 실용화되고 있는 예도 있다. 습동재료로써 CVD-SiC 코팅은, 소결체나 다른 경질 피막에 비해 현재 우위성은 없지만, 탄소의 조성비나 구조를 제어함으로서, 새로운 전개를 도모할 수 있는 가능성이 있다.
4.4 자외광용 밀러
천체 물리 및 싱크로트론 방사광의 분야에서는, 파장이 100 nm이하의 자외역(Extreme Uitraviolet region, EUV)에 대하고, 높은 반사율과 높은 내열성을 가진 밀러의 개발이 대두되고 있다.
이를 위하여, CVD-SiC 코팅은 가장 유망시 되고 있는 재료로써, 이에 대한 많은 연구가 행하여지고 있다. 또한, X선에 의한 손상에도 강하기 때문에, 연X선용 다층막 밀러의 소재로도 응용되고 있다.
CVD-SiC 코팅을 밀러에 응용할 경우, 평활도가 높고, 높은 형상 정도의 초정밀 가공 기술의 개발이 필수불가결하다. 형상 정도 0.25㎛, 표면 조도 5nm를 실현하는 가공 기술[14]과 표면 조도 0.2nm RMS 이하를 실현하는 폴리싱 가공 기술[15]이 보고되고 있다.
4.5 반도체 프로세스용 부품
SiC는 Al2O3와 함께 대표적인 반도체 프로세스 재료로서 알려져 있다. SiC의 다공체에 실리콘(Si)을 함침시키고, 그 표면에CVD법에 의한 SiC를 코팅 한 것이 확산 열처리로의 내열성 부재 등에 종래부터 실용화 되고 있다. 그 후, 고순도화 기술이나 CVD기술방법의 진보에 의해, 더욱 더 이 분야에서의 사용 영역이 확대되고 있다.
최근에는, 반도체 프로세스의 기술의 급격한 발전에 따라 디바이스 성능 및 생산성 향상의 요구에 부응하기 위하여, 1) 보다 높은 온도와 고 부식성 가스 및 용액에서의 처리공정이 필요(내식성 향상), 2) 초미세화 회로 설계를 위해 고순도 및 불순입자(먼지 등)의 저감이 필수, 3) 12인치(300mm)웨이퍼가 주류임으로, 대구경의 치구류가 필요하게 되었다. 이를 위하여, 반도체 치구류는 보다 내식성 및 내열성이 우수하고, 사용수명의 개선이 필요하게 되었고, 본래의 열적, 화학적 특성의 손상 없이 전기적 특성을 제어한 기능성 부품으로서의 요구가 높아지고 있다.
이에 따라서 최근에는 CVD-SiC가 큰 주목을 받게 되었다. CVD-SiC의 주된 특징으로서는, 내부식 및 내약품성 (산 및 알칼리 세정이 가능), 산화분위기에서의 사용이 가능, 초고순도, 불순입자의 발생이 적음(입자의 탈락이 없다), 후막 코팅 가능(수 mm), 내열성, 내마모성, 고 열전도성, 대형부재에서의 코팅이 가능하기 때문에 최근 반도체 프로세스의 치구류의 응용에 각광을 받고 있다.
그림 9에 CVD-SiC소재를 이용하여 반도체 프로세스 부품의 응용 예를 나타내었다[16]. SiC의 도전성, 고 열전도성, 고온고강도를 이용한 제품으로서 웨이퍼 가열 히터가 있다. heater element는 비저항을 1×10-4Ω·m으로 제어한 SiC 소결체를 이용하여 와이어 방전 가공에 의해 제작되고 있다.
이 히터는 300mm사이즈의 Si웨이퍼를 최고 온도 1273K까지 가열 가능하고, 산화막, 고유전체막 등의 성막이나 아닐링 처리 등의 프로세스에 사용되고 있다. 가열시의 가스 방출이 거의 없고, 고온에서의 내산화성이나 내식성도 우수하고, 진공, 산화 분위기, 부식성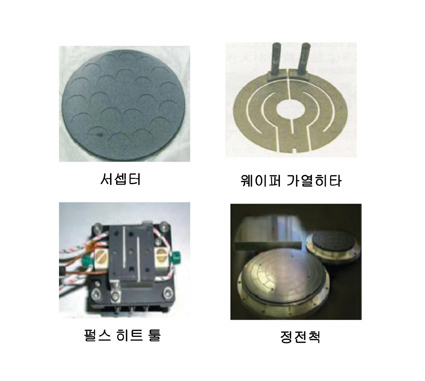 분위기 등의 모든 환경하에서 사용 가능하다.
분위기 등의 모든 환경하에서 사용 가능하다.
펄스 히트 툴은 후립칩 본딩 등의 반도체 실장 프로세스에 넓게 사용되고 있다.
이 제품에는 탁트 타임 단축을 위한 급속 승온 및 하강특성과 균일 압착을 위한 고온내하중 특성, 그리고 수십만회 이상의 반복 부하 동작에 대한 내구성이 요구된다.
종래의 히트 툴에는 질화규소(Si3N4)나 질화알루미늄(AlN) 등의 절연성 세라믹스에 금속 히터를 내장한 것이 사용되고 있었다. 이에 비해, SiC의 비저항을 조절해 발열체로서 응용하면 구조가 심플하게 되어, 열용량도 작아지기 때문에, 종래품보다 뛰어난 급속 승온 및 하강(온도상승 속도 200K/sec, 냉각 속도 100K/sec, 실온∼723K)과 균일 열성능을 겸비한 히트 툴이 실현 되었다. 또한, 고온시의 열변형이 적어 고정밀도이고 신뢰성이 높은 열압착 성능을 얻을 수 있음으로, Si디바이스 이외에 레이저 다이오드나 포토다이오드 등의 광부품 실장용으로도 용도가 확장되고 있다.
최근, 반도체 제조 디바이스의 제조 프로세스에서는 빼놓을 수 없는 저압 플라스마중에서의 에칭이나 CVD 성막을 실시하는 플라스마 처리 장치 등에, 웨이퍼를 정전 흡착력으로 보관 유지, 고정하는 정전 척이 사용되고 있다. 이것은, 종래의 기계적으로 웨이퍼를 척킹하는 방법보다 작업능률을 향상시켰다.
즉, 정전 척을 이용하면 웨이퍼 전면의 처리가 가능해지고, 또한 흡착의 균일성도 향상되기 때문에 웨이퍼의 온도 분포가 균일하게 되어, 에칭이나 성막의 특성이 안정화 되는 장점이 있다.
이러한 정전 척은 절연층을 개입시켜 평면 전극과 웨이퍼의 사이에 전압을 인가하는 것으로, 이 사이에 정전력을 발생시켜 웨이퍼를 흡착시키는 것이다.
5.맺는말
CVD-SiC 코팅은, 파워 반도체 디바이스에서 습동재료나 광학 부품, 반도체 프로세스까지 넓은 분야에서의 응용이 기대되고 있고, 요구되고 있는 재료 특성도 한결같지는 않다. 따라서 CVD 기술도 다른 박막 형성 기술 등과의 융합화에 의해 향후의 발전이 기대된다. SiC가 본래 가지고 있는 뛰어난 재료 특성을 살리면서, 다른 원소와의 복합화 등에 의한 나노 레벨의 구조 제어, 저비용을 고려한 프로세스 기술의 개발이 필요하다.
아울러 응용화의 관점에서 CVD-SiC 코팅의 중요한 기술 포인트로서, (1)공정안정화 (원료, 코팅, 후처리, 평가)에 의한 코스트다운, 불량률 감소, 고품질의 달성, (2) 대형부재 및 다양한 복잡형상에 대한 기술적인 대응, (3) 고부가 가치 기술의 확보(정밀가공 등), (4) 새로운 용도 창출 (내열, 내식성, 마모성의 특성을 살려서 end user와 긴밀한 협력 관계 및 기술영업의 능력배양) 이 중요하다고 사료된다.
참고문헌
1) M. Bhatllagar and B. J.Baliga,IEEE TransactiOns on Electron Devices,40 (1993)645.
2) M. Kitabatake andJ.E Greene,Jpn. J. Appl. Phys., 35 (1996) 257.
3) M. Kanaya, J. Takahashi,Y Fujiwara and A. Moritani, Appl. Phys. Lett., 58 (1991)56.
4) CVD法の總說として “實用眞空技術總覽(橘輝雄 他編、産業技術サ一ビスセンタ一,1990) p676-741.
5) 日本學術振興會 セラミックス材料 第124委員會 SiC系セラミックス新材料、P192.
6) J. Oroshnik et al, J. Electrochem. Soc,115(1968)649.
7) Y. Okamoto and H. Tamagawa,Jpn. J. Appl. Phys,11(1972)726.
8) S.Matsuo and M. Kikuchi, Jpn. J. AppI. Phys., 22(1983)L210.
9) J. D. Bcnnie, J.I.B.Wilson, M.J. Colles and J. L. West, J. Appl. Phys.58 (1985)4446.
10) N. Kuroda,et.al. 19th Conf Solid State Devices and Materials(Tokyo, 1987)p 227.
11) L. F. Pochct, P. Howard and S. Safaie, Sur. Coating Tech.,86-87 (1996)135.
12) 近藤雅之他,日本金屬學會誌, 63(1999)851.
13) 井頭賢一郞他,日本金屬學會誌, 62(1998)766.
14) H. Suzuki and S. Murakami,Nanotechnology,6(1995)152.
15) M.Ando et al,Nanotechnology,6(1995)11.
16) 小西 幹郞, 熱プラズマ法による炭化ケイ素ナノ粒子と半導體プロセス機能部品への應用, P6, テクニカルレポ一ト2009、新材料と光エレクトニクス(住友大阪セメント).
그림 1. CVD프로세스에 의한 SiC막 형성과정
표 1. CVD법의 분류
그림 2. Hot-wall형 감압 CVD장치의 개략도
그림 3. 용량 결합형 플라스마 CVD장치의 개략도
그림 4. 유도결합형 플라스마(ICP) CVD장치의 개략도
그림 5. ECR플라스마 CVD장치의 개략도
그림 6. 엑시머 레이져 CVD 장치의 개략도
그림 7. Y2SiO5내산화 코팅의 개념도
그림 8. CVI법의 개략도
그림 9. 반도체 프로세스 기능 부품에의 응용예
.jpg) 장 병국
장 병국
1981년 연세대학교 요업공학 학사
1994년 동경대학 공학박사
1999년 통산성 산업기술융합영역연구소 네도 연구원
2002년 일본 화인세라믹센타 주석연구원
2003년 메이죠대학 재료기능공학과 강사
2007년 물질재료연구기구 나노세라믹센타 주간연구원
전문 세라믹 프로세싱·나노재료, 나노코팅, 열물성 평가
기사를 사용하실 때는 아래 고유 링크 주소를 출처로 사용해주세요.
https://www.cerazine.net