Special 세라믹 열관리소재 기술 개발 동향(1)
TCB 모듈용 질화규소 히터 소재 개발
박영조_한국재료연구원 엔지니어링세라믹연구실 책임연구원
김미주_한국재료연구원 엔지니어링세라믹연구실 기술기원
김하늘_한국재료연구원 엔지니어링세라믹연구실 실장
마호진_한국재료연구원 엔지니어링세라믹연구실 선임연구원
이재욱_한국재료연구원 엔지니어링세라믹연구실 선임연구원
고재웅_한국재료연구원 엔지니어링세라믹연구실 책임연구원
1. TSV 패키징의 열간압착접합 기술
(1) 관통 실리콘 비아 (TSV : through silicon via) 패키징
기존 와이어본딩 패키징의 경우, 스택 간의 접합을 위해 큰 면적이 요구되며 긴 전기 배선에 의한 칩 간의 전기적·기계적 상호연결에 의한 기생 커패시턴스와 인덕턴스의 증가, 잡음 여유도(noise immunity)와 칩 디자인의 유연성 저하 및 패키징 비용 증가 등이 유발되는 것에 비해 상대적으로 작은 사이즈의 체적이 요구되는 수직 패키징 공정인 TSV 기술이 해결책으로 제안되어 이미 일부 산업화가 이루어지기 시작하고 있다1. 전극을 형성하는 비아의 직경은 머리카락 굵기의 20분의 1 수준인 수 마이크로미터에 불과하며, 기존 와이어본딩 패키징에 비해 칩들 간 신호를 주고받는 시간이 짧아져 속도와 소비전력을 획기적으로 개선할 수 있는 점이 특징이다.
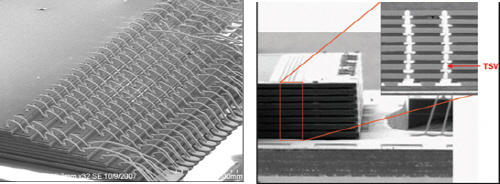
그림 1. 반도체 패키징의 (좌) 기존 와이어본딩 기술 (우) TSV 신기술
(2) 열간압착접합 (TCB : thermal compression bonding) 기술
열간압착접합은 300~400℃ 정도로 가열된 발열체를 스택 상부로부터 눌러 스택 전체에 열간 압축응력을 부가하는 기술로서, ① 수직 비아 내부에 충전된 Cu 분말이 Cu 표면의 두꺼운 산화막을 통과하여 Cu 원자가 용이하게 확산하여 소결됨으로써 전극을 형성하고 ② 스택 간에 삽입된 브레이징 필름에 의한 다층 접합을 형성시킨다. 스택 접합의 생산성 향상을 위해 TCB 모듈을 구성하는 핵심 소재인 히터는 여러 개의 스택을 동시에 압착할 수 있는 대면적 규모에서 급속 승온/냉각과 발열면 전체의 온도 균일성이 요구된다.
2. TCB 모듈용 히터 소재 개발의 필요성
(1) TCB 모듈용 세라믹 히터 소재의 요구 물성
반도체 에피 증착 설비의 히터 소재로는 세라믹 소재 중 높은 열전도도에 의한 웨이퍼 전면의 균일한 온도 전달이 가능한 질화알루미늄(AlN)이 주로 사용되고 있다. 그러나 AlN은 200℃ 이상의 온도에서 절연저항이 현저히 저하되는 문제로 인하여 이를 극복하기 위한 조성 개발이 요구되고 있다2. 또한 급가열 및 급냉에 의한 변형 및 파손이 빈번하게 발생하여 주기적으로 교체가 필요한 소모성 부품으로서 생산성과 직접 연관된 짧은 교체주기의 단점이 크게 작용하고 있기 때문에 열‧기계적 물성 면에서의 획기적인 개선이 요구된다.
탄화규소(SiC)는 AlN과 비교하여 동등 이상의 열전도도를 나타내는 장점이 있지만 발열을 위한 저항 경로의 가공이 필요하기 때문에 발열면 전체의 온도 균일성 면에서는 불리하며, 이러한 단점에 의해 생산성 향상을 위해 중요한 요소인 히터의 대면적화가 근본적으로 불가능한 것이 단점으로 알려져 있다.
질화규소(Si3N4)는 우수한 기계적 물성과 열적 물성의 조합에 의해 다양한 세라믹스 중 최상급의 내열충격성을 보유함으로써3 급속 승온 및 급속 냉각 등의 가혹한 작동환경 하에서 내구신뢰성이 탁월한 소재로 인정되고 있기 때문에 앞에서 소개한 반도체 공정의 신기술로 주목을 받기 시작하고 있는 TSV 패키징 제조 라인의 TCB 모듈의 히터 소재로 활용이 가능할 것으로 기대된다. 한편, 고품질 질화규소 소재는 응용의 확장성도 클 것으로 기대되는데, 고열전도도를 활용하여 발열밀도가 높은 전력반도체 패키징용 기판 소재로 이미 적용이 시작되고 있으며, 고강도를 활용하여 두께 200μm 정도의 기판에 다수의 hall을 가공한 구조인 반도체 프로브카드의 유망한 후보 소재로 검토되고 있다.
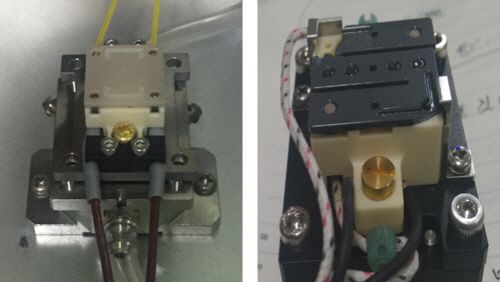
그림 2. 현재 채용되고 있는 (좌) AlN 히터 모듈 (우) SiC 히터 모듈
(2) 질화규소의 히터 소재 산업화를 위한 스케일업 시 4대 문제점
열.기계적 특성을 균형 있게 구비하고 있는 질화규소이지만 난소결성 질화물 세라믹스에서 잘 알려져 있는 대형 제품의 양산화가 산화물 세라믹스에 비해 용이하지 않은 것이 지적되고 있는데, 아래와 같은 문제점을 안고 있기 때문에 이의 해결을 위한 연구개발이 요구된다.
-----이하 생략
_?xml_:namespace prefix = "o" ns = "urn:schemas-microsoft-com:office:office" />
<본 사이트에는 일부 내용이 생략되었습니다. 자세한 내용은 세라믹코리아 2021년 11월호를 참조바랍니다. 정기구독하시면 지난호보기에서 PDF를 다운로드 하실 수 있습니다.>
기사를 사용하실 때는 아래 고유 링크 주소를 출처로 사용해주세요.
https://www.cerazine.net