Special 차세대 AI 산업 핵심 반도체 세라믹 기술 동향(2)
내플라즈마 세라믹 연구의 기초: 오염입자와 crater 구조
이재욱_한국재료연구원 나노재료연구본부 책임연구원
마호진_한국재료연구원 나노재료연구본부 선임연구원
김하늘_한국재료연구원 나노재료연구본부 책임연구원
고재웅_한국재료연구원 나노재료연구본부 책임연구원
김미주_한국재료연구원 나노재료연구본부 기술기원
박영조_한국재료연구원 나노재료연구본부 책임연구원
1. 서론
실리콘 반도체의 집적도가 높아져 회로선 폭이 수 nm 정도로 미세화됨에 따라 각종 패턴을 작고 깊이 새기기 위해 에칭 공정은 더욱 가혹해지고 있다. 대표적으로 에칭 장비의 플라즈마 출력이 수백 와트(W) 수준에서 이제는 kW 수준으로 높아졌는데 이렇게 되면 실리콘 반도체 소재뿐 아니라 주변의 장치 소재 역시 눈에 띄는 속도로 에칭되게 된다. 주변 장치 소재의 에칭은 부품의 치수가 달라져 본래의 기능을 상실하게 된다는 원천적인 문제 외에 소위 오염입자(contamination particle)를 발생시켜 반도체의 불량을 유도하고 장비 세정 주기를 단축시킨다는 문제를 일으킨다. 이런 관점에서 세라믹 소재의 내플라즈마성은 플라즈마 분위기에서 에칭속도(식각률)가 작고 오염입자 발생이 적을수록 우수하다고 판단할 수 있다[1].
몇 년전 내플라즈마 세라믹을 연구하기 시작할 때 맞닥뜨렸던 두 가지 기초적인 의문점은 오염입자가 무엇이냐와 에칭된 세라믹 표면에서 관찰되는 crater(분화구) 구조가 어떻게 형성됐냐는 것이었다. 이 두 가지 단어, 오염입자와 crater는 반도체 제조공정에서 일하는 엔지니어들을 만나면 흔하게 들을 수 있는 용어들이지만 필자처럼 세라믹 제조분야에서 일하는 사람에게는 낯선 것이었다.
더욱이 필자 주변의 동료들뿐 아니라 반도체 엔지니어들조차도 실험 결과 자주 목격하기는 하지만 오염입자와 crater가 어떻게 형성되는지와 이들의 생성을 막으려면 어떻게 해야 하는지를 모르고 있었다. 나중에 문헌 조사나 과제 수행 과정에서 알게 된 바로는 내플라즈마 세라믹이나 플라즈마 물리 분야에서 오랜 경험을 가진 전문가들만 이 현상을 이해하는 듯하다. 그리고 아직도 이 현상에 대한 다양한 의문점들이 이해되지 못하고 남아있다. 본 글에서는 산업현장이나 연구기관에서 내플라즈마 세라믹을 개발하는 연구자들을 위해 오염입자와 crater 구조에 대해 알려진 기초적인 사실을 소개하고자 한다. crater 구조를 설명하기 위해 내플라즈마 세라믹의 에칭 기구에 대해서도 간략히 소개한다.
2. 오염입자


그림 1. 레이저 산란법으로 드러난 웨이퍼 위의 먼지 구름(위)[3]과 SEM으로 확인된 실리콘 오염입자(아래)[2].
1989년 Selwyn 등[2]은 오염입자의 존재를 극적인 방법으로 보고하였다. 그들은 플라즈마 에칭 챔버 안에서 레이저 산란법으로 이온의 농도를 측정하던 중 웨이퍼 위 특정 영역에서 레이저의 산란량이 높아지는 것을 발견하고 챔버 안을 직접 카메라로 촬영한 결과 연못 위 안개처럼 먼지 구름(dust cloud)이 분포함을 발견하였다 (그림 1). 그리고 에칭 후 웨이퍼 위의 먼지 입자들을 SEM으로 관찰하여 지름 수 마이크론 정도의 구형 실리콘 입자임을 확인하였다 (그림 1).
실리콘 웨이퍼 위에서 발견되는, 불량을 일으키는 다수의 미세한 먼지 입자들은 오랫동안 반도체 엔지니어들의 골칫거리였다. 하지만 이 당시 모든 연구자들은 이러한 먼지 입자들이 챔버 밖에서 유입된다고 믿어서 챔버가 설치된 실험실 즉, 클린룸(clean room)의 청결도를 높이는 데에만 집중하고 있었다. 그런데 Selwyn 등의 결과는 미세 먼지들이 챔버 밖이 아닌 안에서 생성된다는 것을 보여줌으로써 연구자들의 관심을 클린룸에서 에칭장비로 돌리는 계기가 되었다고 한다[3]. 실제로 이 결과가 보고되고 몇 년 만에 에칭 장비에 각종 대류장치와 포집기가 설치되고 플라즈마 발생장치도 Capacitively Coupled Plasma (CCP)에서 Inductively Coupled Plasma (ICP) 방식으로 바뀌게 되면서 실리콘 오염입자 문제는 거의 사라지게 되었다고 한다[3, 4].
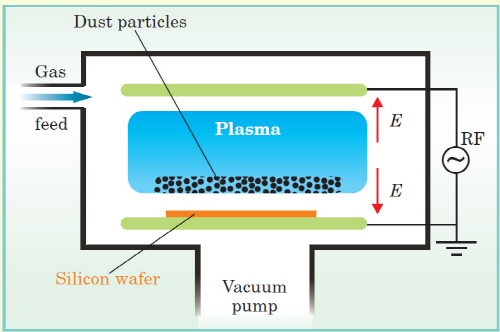
그림 2. 실리콘 오염입자의 생성 과정을 보여주는 모식도[3].
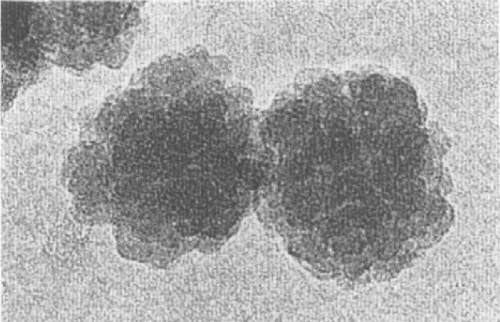

그림 3. 수 나노 크기의 입자들이 합체된 수십 나노 크기의 입자들(TEM 사진, 위)과 시간에 따른 실리콘 오염입자의 크기와 농도 그래프 (아래)[5].
Boufendi 등[5]에 의해 밝혀진, 실리콘 오염입자가 형성되는 과정은 다음과 같다. 플라즈마 생성 후 불과 수 밀리 초 (millisecond) 만에 2nm 크기의 수많은 오염입자들이 그림 2와 같이 실리콘 웨이퍼 위 허공에서 기상 핵생성 과정을 통해 생성된다. 그리고 이 입자들은 그림 3과 같이 5초 만에 합체(agglomeration) 과정을 거쳐 50nm 이상으로 커지고 이들의 숫자(농도)는 감소한다. 그림 1의 오염입자도 수 나노 크기의 입자들이 합체된 입자이다. 긴 시간동안 오염입자가 허공에 계속 떠 있는 것은 오염입자들이 전자를 흡수하여 음전하를 띄면서 플라즈마 sheath 내에서 전기력과 중력의 절묘한 균형을 이루기 때문으로 밝혀졌다[6].
전기장이 꺼지면 입자들은 웨이퍼 위로 떨어졌다가 전기장이 켜지면 다시 허공으로 떠오른다. 그리고 전기장에 갇힌 입자들은 아래로 떨어지지 않을 뿐 아니라 진공펌프가 작동하고 있음에도 밖으로 배출되지 않고 계속 성장하였다. 이와 같이 전하를 띈 분자나 입자가 플라즈마 전기장으로 인해 특정 부위에 고착되거나 특이한 운동을 하게 되는 현상은 이후 발견되는 실리콘 이외의 불화물 오염입자 등에서도 관찰되는데, 이를 예측하고 방지하거나 활용하는 것은 쉽지 않은 것으로 보인다.
플라즈마 내 실리콘 오염입자의 발견은 새로운 과학 분야의 탄생으로 이어졌다. 1980년대에는 반도체 공정에서 플라즈마 오염입자가 발견된 사건과 별개로 태양계를 항해 중이던 보이저 2호가 토성의 고리에서 방사형 빗살(spoke) 패턴이 수 분마다 움직인다는 것을 발견한 사건이 있었다. 이 발견은 토성의 고리가 미세한 먼지들로 뒤덮여 있다는 것을 의미했으며 계속된 연구를 통해 과학자들은 토성의 고리 또한 진공의 플라즈마 상태이며 플라즈마 안에서 엄청난 숫자의 하전된 먼지 즉, 미세 입자들이 형성된다는 것을 밝혀냈다. 이렇게 에칭 챔버 안의 먼지와 토성 고리의 먼지는 서로 전혀 상관없을 것 같지만 동일한 물리적 원리에 의해 지배된다는 사실이 드러났다. 이 두 사건으로 1980년대에 플라즈마 안의 미세입자들을 연구하는 소위 “dusty plasma”라는 과학 분야가 탄생하였다[3, 7].
-----이하 생략
<본 사이트에는 일부 내용이 생략되었습니다. 자세한 내용은 세라믹코리아 2024년 9월호를 참조바랍니다. 정기구독하시면 지난호보기에서 PDF 전체를 열람하실 수 있습니다.>
기사를 사용하실 때는 아래 고유 링크 주소를 출처로 사용해주세요.
https://www.cerazine.net